在先進制程趨于物理極限、芯片封裝邁向三維集成的背景下,熱管理已成為限制高性能計算系統性能釋放的關鍵瓶頸。近年來,金剛石材料憑借其超高導熱率、優異的電絕緣性和結構穩定性,成為下一代芯片散熱的核心材料。而在金剛石散熱材料的技術演進和系統集成方向上,華為已悄然完成從材料設計、鍵合封裝到系統集成的全鏈條布局,并通過系列高價值專利構建起技術壁壘。
去年12月,華為技術有限公司公開了一項新專利:一種半導體器件及其制作方法、集成電路、電子設備,聚焦金剛石散熱層與半導體芯片的結構協同。與傳統散熱思路不同,該專利通過在鈍化層表面設計凹槽結構,使金剛石散熱層在垂直方向上嵌入鈍化層,實現對柵極區域的直接熱耦合。這種結構顯著增加了金剛石層與鈍化層的接觸面積,提高結合強度,同時減少了熱流從柵極到散熱層的擴散路徑,降低熱阻并提升散熱效率。這一創新明確回應了先進芯片在局部熱點區域(如柵極)熱通量急劇上升的挑戰,展示出華為在熱設計細節上的深度思考。
華為對金剛石材料的熱管理潛力早有系統性認識。早在2023年3月,其兩項芯片導熱材料相關專利就已提出以金剛石顆粒材料為主要導熱介質,結合復合界面填料顯著提升芯片封裝界面導熱性能。與傳統硅脂或金屬填料相比,金剛石復合材料展現出更優異的各向異性熱導能力,并具備更強的機械穩定性。就此來看,華為已不僅將金剛石視為一項“替代材料”,而是正在以金剛石為基礎構建新一代芯片熱管理框架。

值得注意的是,華為并未將金剛石散熱材料的研究僅局限于顆粒分散或金屬復合等材料級別的優化,而是逐步推進至三維集成芯片系統的工程應用層面。2023年11月,其與哈爾濱工業大學聯合公開的“一種基于硅和金剛石的三維集成芯片的混合鍵合方法”專利,提出通過混合異質材料(包括金剛石與石墨烯)的界面調控,實現大尺寸低熱阻的三維鍵合結構。金剛石提供垂直方向高效散熱通道,石墨烯則通過其橫向導熱能力協同均熱,構成復合散熱網絡結構,為3D封裝芯片中“堆疊發熱”問題提供了系統性解決路徑。
在結構創新之外,華為也在積極攻克金剛石材料與現有封裝體系的工藝匹配難題。2024年2月,華為聯合廈門大學團隊,率先實現將多晶金剛石襯底集成于先進玻璃轉接板背面封裝結構中。這一低溫鍵合技術攻克了金剛石在高溫熱處理中易碎裂、應力失配大的問題,同時與玻璃轉接板形成熱、電、力多維兼容接口,使得金剛石不僅僅作為“被動散熱體”嵌入系統,而是以熱功能核心部件角色服務于先進封裝架構,特別適用于高算力、低延遲的5G通信芯片和AI加速芯片封裝需求。
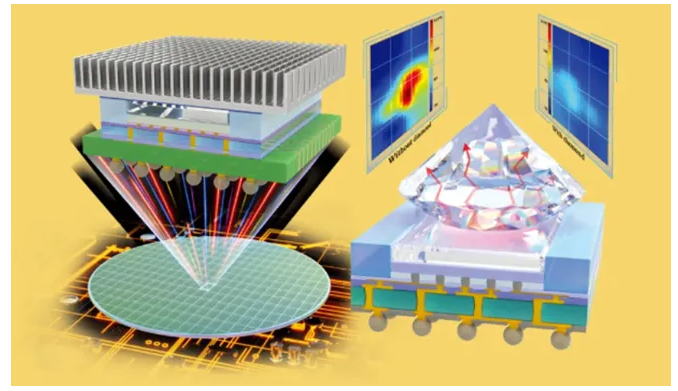
7月17日,華為最新公布的銅-金剛石復合散熱基板專利(授權公告號CN223110366U),更是將金剛石應用從點狀的“嵌入式散熱”向大面積復合底板方向拓展。該基板采用銅金剛石復合材料填充于金屬框架通孔中,并通過上下雙金屬層與系統電熱結構焊接連接,從而實現高強度熱傳導與機械固定的雙重功能。這種復合結構不僅提升整體熱擴散能力,也為異構芯片封裝提供了優良的熱匹配平臺,特別適用于服務器、基站與數據中心領域的高功率芯片需求。
從技術演進路徑來看,華為的金剛石散熱布局呈現出由材料開發、封裝集成到系統熱管理三位一體的多層協同趨勢。其中,專利布局體現出其對“熱耦合結構—界面材料—封裝工藝—系統平臺”的系統性掌控,而非單點材料性能突破。這一趨勢與全球高性能芯片散熱面臨的現實挑戰高度契合。國際上,包括Intel、TSMC、NVIDIA等廠商也在加快導熱界面材料(TIM)、微流體散熱、金剛石熱板等方向的探索,但多數仍處于樣品驗證與初步試產階段。
當前,隨著AI訓練芯片功耗持續攀升,傳統銅-石墨散熱方案逐漸失效,金剛石因其高導熱、低熱阻特性受到產業鏈廣泛關注。但同時,金剛石的成本、加工難度和工藝集成壁壘也是限制其規模化應用的核心障礙。華為通過與高校團隊協作、推進低溫鍵合、結構優化和復合化路徑,降低了金剛石材料的系統應用門檻,有望推動其率先落地于智能手機、數據中心、光通信等中高端散熱場景。
更值得關注的是,華為在金剛石材料技術上的布局不僅服務于其自研芯片的性能釋放,也構建起未來新型器件與系統的生態基礎。以其三維集成散熱專利為例,既可用于SoC堆疊芯片封裝,也具備拓展到量子芯片、光電集成芯片等高熱密度系統的潛力。
目前,金剛石散熱技術正在從科研探索向工程實現邁進。華為不僅在材料創新上構筑壁壘,更在封裝設計、工藝協同及系統集成方面完成關鍵技術閉環。隨著專利的不斷落地與產業配套的完善,華為有望率先實現金剛石散熱材料的多場景規模化應用,并進一步重構高端芯片散熱技術的全球競爭格局。


 手機資訊
手機資訊 官方微信
官方微信








 豫公網安備41019702003604號
豫公網安備41019702003604號